北理工在巨斯塔克效應(yīng)驅(qū)動(dòng)的軌道柵控用于實(shí)現(xiàn)高性能隧穿光電晶體管方面取得重要進(jìn)展
發(fā)布日期:2022-03-07 供稿:物理學(xué)院
編輯:王莉蓉 審核:姜艷 閱讀次數(shù):電柵控通常是當(dāng)前許多電子和光電器件的核心操作。電柵控可通過(guò)各種方法執(zhí)行,包括場(chǎng)效應(yīng)晶體管(FET)中的外部柵極偏置、閃存中的俘獲電荷以及光電探測(cè)器中的光柵控效應(yīng)。所有這些柵控策略都針對(duì)傳統(tǒng)3D器件進(jìn)行了優(yōu)化。因此,尋求對(duì)低維材料(例如層狀材料)進(jìn)行柵控的替代方法來(lái)實(shí)現(xiàn)概念上的高性能新光電器件變得非常必要。特別是,沒(méi)有復(fù)雜制造過(guò)程的柵控機(jī)制對(duì)于探索基于低維材料的新型功能器件是當(dāng)前的一個(gè)努力方向。源自外部電場(chǎng)層間電位梯度的巨斯塔克效應(yīng)是原子薄層狀半導(dǎo)體的獨(dú)特特征。正如之前研究報(bào)道的那樣,層間激子峰可以被外部電場(chǎng)分成幾個(gè)獨(dú)立的分支。層間激子峰之間的能量分裂高達(dá)120 meV,是傳統(tǒng)斯塔克效應(yīng)的100倍。但其潛在的優(yōu)勢(shì)尚未得到充分認(rèn)識(shí)或充分用于器件應(yīng)用。范德華(vdW)半導(dǎo)體中的弱層間相互作用會(huì)在幾納米的層狀半導(dǎo)體厚度上產(chǎn)生數(shù)十毫電子伏(meV)的能帶偏移。然而,到目前為止,沒(méi)有復(fù)雜表面狀態(tài)的vdW半導(dǎo)體中的表面光伏(SPV)仍未被探索,盡管它有望實(shí)現(xiàn)基于能帶偏移的新器件功能,即通過(guò)巨斯塔克效應(yīng)的選擇性軌道柵控。
日前, 北京理工大學(xué)孫林鋒教授和韓國(guó)科學(xué)技術(shù)高等研究院(KAIST)Heejun Yang教授和(共同通訊作者)等合作在基于2H-MoTe2的隧穿光電晶體管中展示了由巨斯塔克效應(yīng)驅(qū)動(dòng)的軌道柵控,而無(wú)需在光柵控中使用外部柵控偏置或慢速電荷俘獲動(dòng)力學(xué)的調(diào)控。光照的原始自柵控通過(guò)打開(kāi)和關(guān)閉巨斯塔克效應(yīng)來(lái)調(diào)節(jié)層間電位梯度,其中Mo原子的dz2軌道起主導(dǎo)作用。軌道柵控將MoTe2頂部原子層的電子能帶移動(dòng)了高達(dá)100 meV,這大約相當(dāng)于通過(guò)電柵控調(diào)制7.3×1011 cm-2的載流子密度。由于抑制了傳統(tǒng)的光電導(dǎo),隧穿光電晶體管中的軌道柵控同時(shí)實(shí)現(xiàn)了低暗電流、實(shí)用的光響應(yīng)率(3357 AW-1)和快速on/off切換時(shí)間(0.5 ms)。文章以“Orbital Gating Driven by Giant Stark Effect in Tunneling Phototransistors”為題發(fā)表在頂級(jí)期刊Advanced Materials上。

圖1. 隧穿光電晶體管中MoTe2 K能帶邊緣的軌道柵控。(A)基于四層MoTe2和h-BN隧穿勢(shì)壘的隧穿光電晶體管的示意圖。(B&C)MoTe2 K能帶邊緣和Q能帶邊緣層相關(guān)的電子概率密度。(D&E)黑暗條件下和光照下隧穿光電晶體管的能帶示意圖。
MoTe2隧穿光電晶體管的示意圖如圖1A所示。使用h-BN薄層(≈7 nm厚)作為隧穿勢(shì)壘,同時(shí)也可以鈍化MoTe2器件溝道。h-BN的厚度選擇是以平衡黑暗和光照條件下的電流來(lái)決定的,從而達(dá)到器件應(yīng)用需要的小暗電流和大光電流。實(shí)驗(yàn)證明, 當(dāng)h-BN的厚度為7 nm時(shí),響應(yīng)率可以最大化。較厚的h-BN產(chǎn)生微弱的隧穿電流,而較薄的h-BN通過(guò)漏電流削弱軌道柵控,從而降低頂部MoTe2層的累積電荷密度。然而,本文在隧穿光電晶體管中構(gòu)思了一種帶有h-BN層的新型軌道柵控。除了作為隧穿勢(shì)壘的作用外,h-BN介電層在下方MoTe2中產(chǎn)生逐層電勢(shì)梯度,這被稱(chēng)為巨斯塔克效應(yīng)(圖1B-D)。h-BN中俘獲的正電荷施加外部電場(chǎng)(圖1B和C中的x軸)并將電子吸引到MoTe2的頂部原子層。層相關(guān)的電子積累隨原子軌道而變化。Mo原子的d軌道,尤其是布里淵區(qū)K點(diǎn)的dz2軌道,在將電子積累到頂層中起主導(dǎo)作用,如圖1B中的黑色箭頭所示,而Te的p軌道原子,尤其是Q點(diǎn)的pz軌道,對(duì)電勢(shì)梯度的貢獻(xiàn)很小(圖1C)。注意到導(dǎo)帶在K點(diǎn)和Q點(diǎn)的軌道特性是不同的,Q帶主要由沿面內(nèi)方向擴(kuò)展的軌道組成(即dxy+dx2-y2),而K帶主要由沿面外方向(即dz2)分布的軌道組成。因此,Q帶和K帶之間的能帶偏移會(huì)因施加的電場(chǎng)而改變,并且相當(dāng)多的電子可以在電場(chǎng)作用下占據(jù)K帶。
層間電勢(shì)梯度源自h-BN在垂直方向上的Thomas-Fermi屏蔽,產(chǎn)生了原子薄層狀半導(dǎo)體厚度相關(guān)的功函數(shù)。對(duì)h-BN層覆蓋的2H-MoTe2的KPFM研究表明,隨著MoTe2厚度增加,功函數(shù)降低,這個(gè)結(jié)果與沒(méi)有使用h-BN覆蓋的2H-MoTe2形成對(duì)比。減小的功函數(shù)表明從襯底向下的逐層電勢(shì)轉(zhuǎn)移,如圖1D所示。費(fèi)米能級(jí)接近頂部MoTe2層的導(dǎo)帶,有效地屏蔽了固定在h-BN中的原生正電荷。光誘導(dǎo)軌道柵控的關(guān)鍵如圖1E所示。當(dāng)能量大于MoTe2帶隙的光照射時(shí),會(huì)產(chǎn)生光激發(fā)的電子和空穴,并通過(guò)Mo原子的d軌道被電位梯度替換,電子通過(guò)圖1D中的初始能帶排列向MoTe2的頂面移動(dòng)。在h-BN層存在的情況下,電子不能自由地轉(zhuǎn)移到電極上,因此積累在頂部的MoTe2層中。累積的電子更有效地屏蔽了固定在h-BN中的正電荷,并使下面原子層(靠近襯底的兩層)的能帶變平,如圖1E所示。因此,初始能帶彎曲(來(lái)自h-BN垂直屏蔽的巨斯塔克效應(yīng))被光照改變,在MoTe2的頂部原子層中積累更多電子(光摻雜效應(yīng))。然而,在光照下沒(méi)有電位梯度(能帶彎曲)時(shí),下面的原子層不能有效地貢獻(xiàn)光電流。
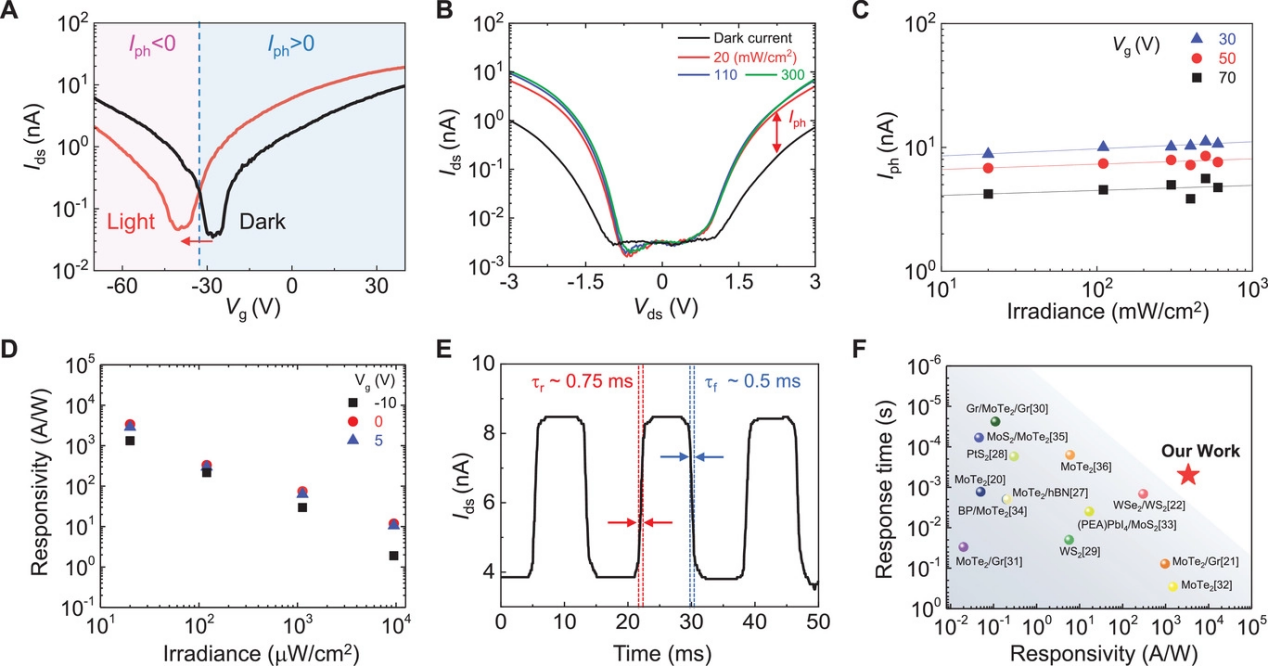
圖2. 隧穿光電晶體管性能。(A)黑暗條件和光照條件下的轉(zhuǎn)移曲線(xiàn)。(B)在黑暗條件和三種不同功率激光照射下,Ids與Vds的關(guān)系。(C)在Vg="30、50和70V且Vds=3V時(shí),光照下功率相關(guān)的光電流。(D)在三個(gè)不同柵極電壓(λ=638nm)下,響應(yīng)率與光功率密度的關(guān)系。(E)時(shí)域中的光電晶體管開(kāi)關(guān)操作。(F)光電晶體管的響應(yīng)時(shí)間和響應(yīng)率的比較。
在圖2A的雙極性轉(zhuǎn)移曲線(xiàn)中觀察到MoTe2頂部原子層中累積電子的柵控效應(yīng)。隧穿電流(漏-源溝道電流,Ids)主要由頂部MoTe2層(即頂部原子層的選擇性軌道柵控)的載流子密度變化調(diào)制,隧穿概率隨距離呈指數(shù)下降,這對(duì)來(lái)自下方MoTe2層的隧穿電流的貢獻(xiàn)很小。因此,在本研究中,vdW材料中的原子間逐層電勢(shì)梯度,也稱(chēng)為巨斯塔克效應(yīng),首次用于軌道相關(guān)的電子器件應(yīng)用。特殊的光柵控表現(xiàn)為光照下溝道電流(Ids)相對(duì)于柵極電壓(Vg)的非平凡水平移動(dòng)。傳統(tǒng)的光電探測(cè)器表現(xiàn)出由光激發(fā)的載流子在水平(光柵控)和垂直(光電導(dǎo))方向上的轉(zhuǎn)移曲線(xiàn)移動(dòng)。水平移動(dòng)方向(ΔVg)表示隧穿輸運(yùn)中的電子?xùn)趴兀ǚe累),其方式與電柵控(例如頂柵控和雙柵控)等效。感應(yīng)的電子密度可以通過(guò)平行板電容器模型估算,圖2A中的ΔVg對(duì)應(yīng)于7.3×1011 cm-2的載流子密度。柵極電壓閾值偏移主要取決于h-BN層的固定電荷密度,在該研究中無(wú)法對(duì)其進(jìn)行調(diào)制。MoTe2和h-BN的厚度幾乎不會(huì)改變柵極電壓閾值偏移。使用巨斯塔克效應(yīng)的軌道柵控?zé)o需復(fù)雜的柵極電介質(zhì)或偏置,可以模擬傳統(tǒng)的電柵控。巨斯塔克效應(yīng)的軌道柵控機(jī)制與傳統(tǒng)的光柵控機(jī)制完全不同。在具有光柵控功能的傳統(tǒng)光電器件中,由于光激發(fā)的電子或空穴被困在局部陷阱態(tài),因此通過(guò)向溝道施加?xùn)艠O電場(chǎng)會(huì)產(chǎn)生很長(zhǎng)的特征時(shí)間(最多幾分鐘)來(lái)打開(kāi)和關(guān)閉溝道。在圖1所示的新型柵控中,通過(guò)軌道相關(guān)的電荷積累對(duì)垂直屏蔽的改變是光電晶體管開(kāi)關(guān)的關(guān)鍵操作,可以由小于1 ms的時(shí)間常數(shù)控制。
圖2B和C中顯示的光電流飽和結(jié)果證明了器件中光電導(dǎo)的獨(dú)特抑制。飽和效應(yīng)可以通過(guò)MoTe2中 “nullified”的內(nèi)建電勢(shì)來(lái)解釋?zhuān)?lèi)似于傳統(tǒng)半導(dǎo)體的SPV研究。當(dāng)光以大于傳統(tǒng)半導(dǎo)體帶隙的能量照射時(shí),在表面附近彎曲的能帶變平,勢(shì)能差異被衡量為SPV。在沒(méi)有電位梯度的情況下,光激發(fā)的電子和空穴不再對(duì)電流做出貢獻(xiàn),電位梯度由Thomas-Fermi屏蔽通過(guò)vdW間隙進(jìn)行調(diào)制。巨斯塔克效應(yīng)驅(qū)動(dòng)的柵控最顯著的優(yōu)勢(shì)是改善的上升/下降時(shí)間和高響應(yīng)率。圖2E顯示了軌道柵控器件的獨(dú)特開(kāi)關(guān)動(dòng)力學(xué),可以在20 μW cm-2的輻照度下保持高光響應(yīng)率(3357 AW-1,對(duì)應(yīng)于6×105 %的外量子效率)(圖2D)。雖然器件在黑暗和光照條件下的電流表現(xiàn)出隧穿輸運(yùn)(圖2B),但均勻的h-BN層在漏-源電壓Vds上形成對(duì)稱(chēng)的Ids。上升和下降過(guò)程的時(shí)間常數(shù)分別為0.75和0.5 ms。與其他2D材料基FET和具有傳統(tǒng)光柵控機(jī)制的光電探測(cè)器相比,這種隧穿光電晶體管展現(xiàn)了出色的響應(yīng)率和快速響應(yīng)(圖2F)。

圖3. 表面光電壓表征。(A)用于研究接觸電位差(VCPD)的KPFM基測(cè)量裝置的示意圖。(B)拉曼強(qiáng)度成像。(C)形貌圖像。(D&E)在黑暗條件和λ="635" nm光照下的接觸電位差(VCPD)成像。(F)SPV成像,由VCPD在黑暗條件下和光照條件下的差異定義。
新的柵控機(jī)制,即巨斯塔克效應(yīng)驅(qū)動(dòng)的柵控,可以從光輔助的KPFM研究中得到支持,如圖3A所示。為了定量研究屏蔽效應(yīng),在不同厚度MoTe2上覆蓋了h-BN,從而形成了MoTe2/h-BN的異質(zhì)結(jié),其拉曼強(qiáng)度和AFM圖像如圖3B和C所示。隨著MoTe2層數(shù)的變化,拉曼強(qiáng)度顯示出明顯的差異。接觸電位差(VCPD),定義為針尖和頂部h-BN之間的真空能級(jí)差,在圖3C-E中的黑暗和光照條件下與AFM形貌同時(shí)成像。然后通過(guò)從圖3E中減去圖3D在圖3F中獲得SPV。MoTe2不同厚度區(qū)域的非零SPV表現(xiàn)出相似的值(-50 mV)。相似的SPV值由固定在h-BN層中的正電荷量決定,可以通過(guò)能帶偏移來(lái)解釋?zhuān)钩攲又獾腗oTe2層的能帶變平,以屏蔽h-BN層中的固定電荷并控制隧穿電流(即MoTe2中的電荷重新分布)。

圖4. SPV特性的解釋和相應(yīng)的能帶圖。(A)在黑暗條件下與MoTe2厚度相關(guān)的VCPD和SPV值。(B)在黑暗條件下和光照下,三種不同厚度(由h-BN層覆蓋)MoTe2的時(shí)間分辨VCPD測(cè)量。(C&D)在黑暗條件和光照下,被h-BN層覆蓋的4層和12層MoTe2的能帶示意圖。
12層區(qū)域在黑暗條件下的VCPD呈現(xiàn)出更亮的顏色,表明與其他層區(qū)域相比,真空能級(jí)差更小。注意到MoTe2的厚度小于Thomas-Fermi屏蔽長(zhǎng)度或材料的耗盡寬度,這會(huì)產(chǎn)生厚度相關(guān)的VCPD或功函數(shù),圖4A和B總結(jié)了在黑暗和光照條件下不同厚度異質(zhì)結(jié)的VCPD和SPV。黑暗和光照條件產(chǎn)生了可逆且可靠的KPFM信號(hào),表明異質(zhì)結(jié)中沒(méi)有發(fā)生相變或不可逆變化。SPV揭示了光照條件下異質(zhì)結(jié)的能帶對(duì)齊,如圖4C和D所示。電子在黑暗條件下由K能帶邊緣電子形成的電位梯度移動(dòng)到頂面,通過(guò)光照電荷重新分布使下層的能帶變平。圖4D中的能帶圖與圖1D和E中的機(jī)制和圖2C中的飽和光電流一致。光照條件下接觸電位差的幅度大于其在黑暗條件下的值。
文獻(xiàn)信息:Orbital Gating Driven by Giant Stark Effect in Tunneling Phototransistors ( Adv. Mater. , 34(6) 2022, 2106625.)
文獻(xiàn)鏈接:https://onlinelibrary.wiley.com/doi/10.1002/adma.202106625
分享到:
